FIB-SEM原理及应用
2022-11-23 16:43:00 0 1390
聚焦离子束扫描电子显微镜(Focused Ion Beam-Scanning Electron Microscope,简称FIB-SEM)双束系统是指同时具有聚焦离子束(FIB)和扫描电子显微镜(SEM)功能的系统。通过结合相应的气体沉积装置,纳米操纵仪,各种探测器及可控的样品台等附件,成为一个集微区成像、加工、分析、操纵于一体的分析仪器,广泛应用于物理、化学、生物、新材料、农业、环境和能源等众多领域。
FIB-SEM双束系统是将FIB系统与传统的扫描电子显微系统成一定角度同时安装在一台设备上,并将样品调整至共心高度的位置。这样在测试过程中,可以通过旋转样品台,使样品表面垂直于电子束或离子束,最终实现电子束实时观察及离子束切割或微加工的功能。
在常见的双束FIB-SEM系统中:电子束垂直于样品台,离子束与样品台呈一定的夹角,工作的过程中需要把样品台旋转至52度位置,此时离子束与样品台处于垂直状态,便于进行加工,而电子束与样品台呈一定的角度,可以观测到截面内部的结构。
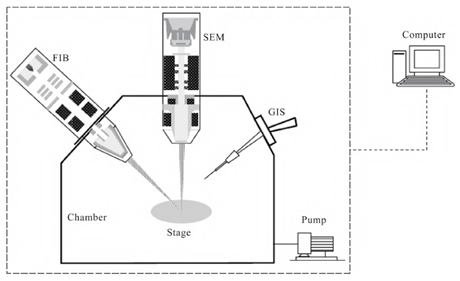
图1. FIB-SEM双束系统的结构示意图
离子镜筒的结构示意图如下图所示。目前应用最广泛的是液态镓(Ga)离子源,因为Ga元素具有低熔点、低蒸气压的特点,同时Ga离子易获得高密度束流,可以刻蚀大部分材料。Ga加热后会向下流到钨针尖尖端,由于表面张力和相反方向电场力的作用,Ga会在针尖形成一个尖端半径仅约2 nm的锥形体; 随后,作用在尖端上的巨大电场(>108V/cm)会使Ga原子电离并发射出来。Ga离子束通过静电透镜被聚焦在样品上并进行扫描,与样品发生相互作用,收集产生的各种信号,从而实现对样品的精细加工和显微分析。
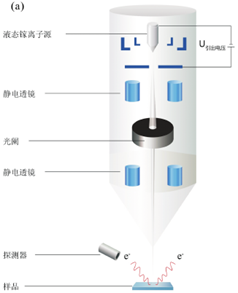
图2. FIB-SEM 双束系统工作原理示意图
1、FIB-SEM的主要功能包括:
①电子束成像,用于定位样品、获取微观结构和监测加工过程;
②离子束刻蚀,用于截面观察和图形加工;
③气体沉积,用于图形加工和样品制备;
④显微切割制备微米大小纳米厚度的超薄片试样(厚度小于<100 nm),用于后续的TEM和同步辐射STXM等相关分析;
⑤显微切割制备纳米尺寸的针尖状样品,用于后续的APT分析,获取其微量元素和同位素信息;
⑥综合SEM成像、FIB切割及EDXS化学分析,对试样进行微纳尺度的三维重构分析等。
2、FIB-SEM的主要应用:
①微纳结构加工;
②截面分析;
③TEM样品制备;
④三维原子探针样品制备;
⑤芯片修补与线路修改
⑥光刻掩膜版修复;
⑦三维重构分析等。
推荐文章
-
【e测试干货】手把手教你使用 Zeiss Supra55扫描电子显微镜
2020-10-28 3 2876
-
2021-06-22 0 1387
-
2022-11-25 0 1114
-
2022-12-23 0 878
-
2021-12-01 0 821






















